���������δ����FPC�댧�w���b�ξߵ�ͻ���Խ�Q����
�ڰ댧�w���b����ܶȡ��ͻ��~�M���M���У����y�����ξ��џo���M��FPCܛ�Ծ�·��ľ��ܼӹ����|ݸ·�ǿƼ������аl�����������m�����b�ξ�ͨ�^��-��-����λ�fͬ���g�����F��0.05mm����FPC����p�����b�������A�����b����������99.5%���ϡ�
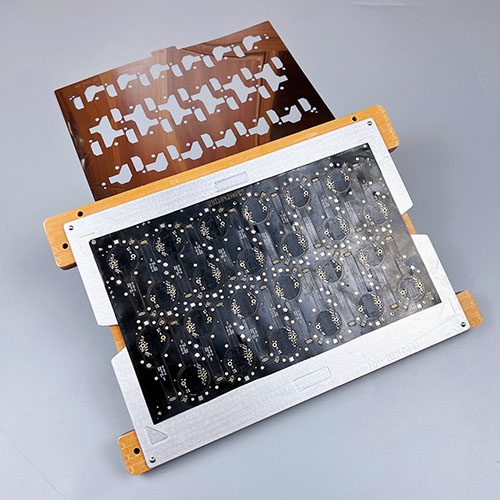
���gͻ���ؘ��ИI�˜�
�{�����|����
����������������+߅�������a���pģϵ�y����QFPC�N�����µ��N�bƫ�Ɔ��}��оƬ��λ�����_��1.5��m���^���y��������3�������ܲ��τ���
���弯��ʯīϩ�ؿ،ӣ���-196��~300��h���±��֟���Ûϵ��С��0.5ppm/�棬ƥ��댧�w�����b��ˇ���ڡ�ȫ���̼����OӋ
�ɓQʽ�ŘOģ�K��֧�֏�QFN��BGA��12�N���b��ʽ�ГQ�������O��M��5G���lģ�M���ۯB����IC��ǰ������

�a�I�����C
ij���H��y���^����ԓ������FPC������b���ڿs����8��/Ƭ�������ξߟo�����x����Ⱦ���ԣ�ʹоƬ�ɿ��Ԝyԇͨ�^��������98.7%��
�����¼oԪ
�҂����_�l���\��ϵ�y��ͨ�^���r�O�yFPC��׃�����ӑB�����ξ߅������ƄӰ댧�w���b�M���������ܕr����

